장비

스크린프린터
용도
인쇄회로기판 상에 솔더크림 인쇄
사양
시료크기: W350 × D300 mm
인쇄정밀도: 0.02 mm
옵션: 공기가압방식 마스크분리

칩 마운터
용도
솔더크림이 인쇄된 회로보드 상에 소형 수동소자 칩 및 전자패키징 부품을 빠른 속도로 자동 실장
사양
시료크기: W400 × D400 mm
최대장착능력: 45,000 CPH
옵션: 트레이피더 (QFP, BGA 장착 가능)

대기 리플로우
용도
칩 실장이 완료된 전자회로보드의 솔더링 & 경화
사양
최대온도 : 450 °C
존 수: 히팅 9존 / 쿨링 1존
시편크기 : W400 × D400 mm

플립칩 본더
용도
C4 공정에서 플립칩과 기판의 얼라인 & 미세피치 플립칩의 열압착 공정
NCA를 사용한 열압착 공정
사양
최대온도: 450 °C
최대 하중: 100 N
Bonding accuracy: 5 μm(3σ)

레이저리플로우
용도
Tg(유리전이온도)가 낮은 유연 기판에 부품 접합 공정
Warpage에 민감한 부품 접합 공정
웨어러블 기판의 저온 접합 공정
사양
Wavelength: 1070 nm (CW, ytterbium fiber)
Laser power: Max. 1 kV
X,Y stroke: 200 x 200 mm

초음파 본더
용도
Au, Cu, Ag, Ni 등 금속재료에 대한 초음파 용접ᆞ접합
사양
Frequency: 40 kHz
Power: Max. 800 W
Pressure: 5 ~ 2000 kgf

플라즈마 전처리기
용도
시편의 표면 개질에 따른 세정 및 식각 공정
사양
LF: 20 ~100 kHz with 300 W Max.
RF: 13.65MHz wit 300 W or 600 W
Gauge pressure: Atm ~ 5x10-4 Torr
시편크기: 330 mmx350 mmx340 mm

와이어 본더
용도
Au, Al, Cu, Ribbon에 대한 스터드 범핑 및 미세 와이어 본딩
Ball to wedge, Wedge to wedge bonding
사양
Au, Al wire diameter: 17~ 75 μm (Max. 3 mil)
Ultrasonic system: 63.3 kHz transducer PLL control
Ultrasonic power: 0 ~ 10 W
Bonding force: 5 ~ 150 cN
Stage temp.: Max. 250 °C

다이본더
용도
칩과 기판 정밀 정렬 후 초음파 또는 열압착 접합
금속 페이스트를 사용한 소결 접합 가능
접합소재 : 접착제, nano-foil, solder, eutectic solder
사양
Ultrasonic horn: 40 W / 60 kHz
Stage size: 50 mm x 50 mm
Bonding force: 20 g ~ 400 g (option: max 25 kg)
Bonding accuracy: 10 μm
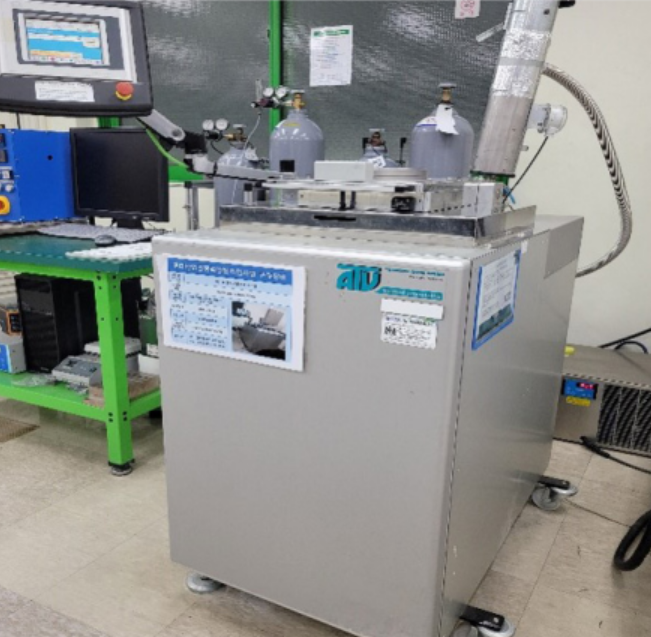
진공 리플로우
용도
리플로우시 불활성 가스 분위기, 개미산 및 진공 환경을 조성하여 Flux less, oxidation/void free 솔더링 구현
사양
Direct substrate IR heating/N2 cooling
100 steps/program
Stage size: 314 x 314 mm
Temperature: R.T ~ 450 °C
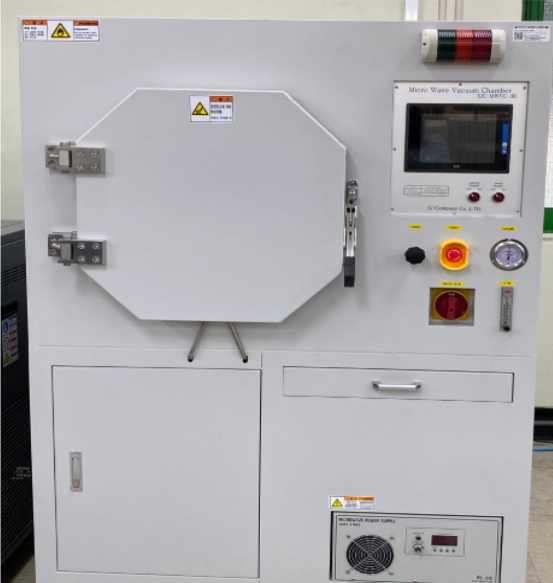
마이크로 웨이브 접합장비
용도
2450 MHz 주파수의 마이크로웨이브를 흡수하여 열을 방출할 수 있는 소 재에 대해 마이크로웨이브를 조사하여 국부적인 가열을 유도하여 접합
사양
마이크로웨이브 제너레이터(파장 : 2450 MHz, 출력 : 최대 3 kW)
마이크로웨이브 가이드 조사면적 : 최대 30 x 30 cm
진공 챔버: 대기/진공/질소 분위기

4″웨이퍼 다이본딩기
용도
Wafer to wafer, die to wafer에 대해 진공 분위기에서 대면적 열압착 가능
사양
시편 대응 크기 4” 이하
온도: 30 ~ 400 °C
압력: 100 kg
진공도: 1 x 10-2 이상

세라믹 접합 시스템
용도
대면적 세라믹 히터 기판 및 대면적 웨이퍼에 대한 진공, 가스분위기 등의 열압착 접합
사양
시편 대응 크기 12” 이하
온도: 30 ~ 300 °C
압력: 150 kg
진공도: 1 x 10-2 이상

디스펜서
용도
접합소재(액상 및 페이스트)에 대한 미세 도포 및 패턴 도포
사양
Dispense pressure setting: 30 ~ 500.0 kPa
Supply air pressure: 600 kPa (dispense pressure +100 kPa)
Vacuum pressure setting: 0 ~ -20.0 kPa
Dispensing time: 0.001 ~ 9999.999 s
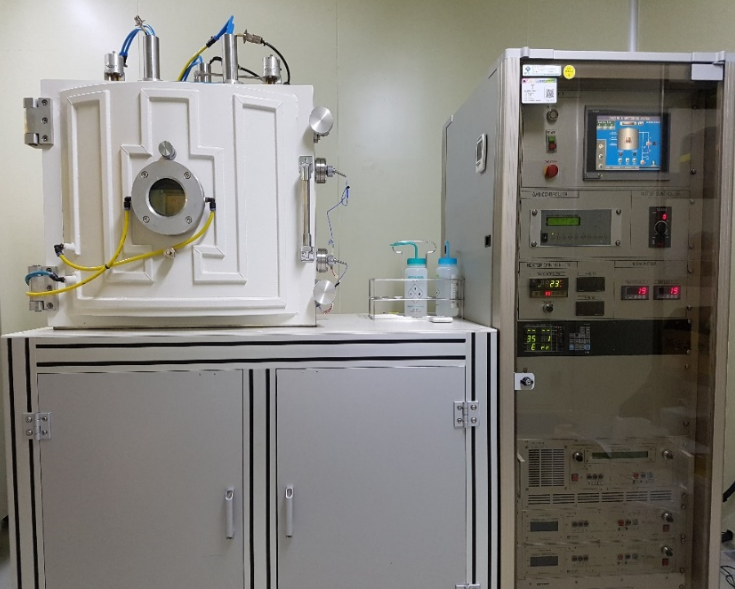
스퍼터
용도
다양한 금속 타겟을 이용한 미세 박막 증착
사양
보유 금속 타겟: Cu, Au, Ni, Ti, Cr
Vacuum pressure: 3 x 10-6 (상온), 1 x 10-5 (200 °C)
챔버 온도: Max. 300 °C
DC power supply: 500 V / 4 A

다이싱머신
용도
미세피치 부품의 마이크로 섹셔닝 및 웨이퍼 다이싱
사양
Spindle speed: 30000 RPM ~ Max. 50000 RPM
Inverter: 1.2 kW, 200V
Max. specimen size: height 500 μm 이하

스핀 코터
용도
원심력을 이용해 웨이퍼 위에 액상의 재료(PR) 코팅하여 박막 제조
사양
Spin Substrate size 370 mm x 470 mm
Sped range: Max. 2000 rpm
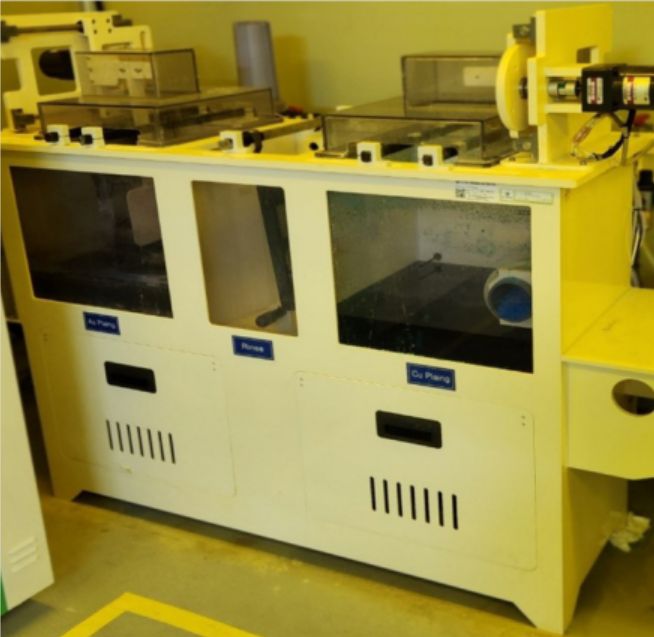
전해도금조
용도
전해도금을 이용한 범프형성
Cu pillar bump, 금속 패드, Sn cap bump etc. 도금
사양
샘플 크기: 8” 웨이퍼 이하
최대 전류: 2 A
도금조 2개 : 15 L / EA
Cu, SnAg

노광기(UV)
용도
UV를 포토마스크와 시편에 노출시켜 PR 패터닝 형성
사양
Mask size: Max. 7 x 7 (Inch)
Substrate size: piece to 6 x 6 (Inch)
UV lamp & Power: 1 kW & power supply

SPI
용도
인쇄된 솔더크림의 3D 불량 검사
사양
Color 3D SPI
Inspection size: Min. 50 x 50 mm Max. 330 x 330 mm
X/Y pixel resolution: 10 ~ 15 μm
Height accuracy: 2 μm

AOI
용도
Chip 실장 불량 및 솔더링 단락에 대한 결함 검사
사양
PCB : 10 x 20 mm ~ 350 x 250 mm
FOV : 15 x 11.3 mm, 23 um/pixel

젖음성 시험기
용도
부품의 솔더 젖음성 평가
PCB의 표면처리 및 솔더 조성에 따른 젖음성 측정
사양
측정범위 : - 30 mN ~ 30 mN (정밀도 ± 0.5 mN)
온도상승속도표준 : 3 °C / sec
측정솔더 온도: 0 ~ 450 °C
자동 플럭스 도포

점착력 시험기
용도
솔더 크림의 조성, 파우더 입자, 플럭스 성분 및 함유량에 따른 점착력 측정
사양
하중센서: -20 ~ 400 gf
센서정밀도: ± 2 gf
프레스 시간: 0.1 ~ 99.9 s
온도: 10 ~ 250 °C

점도 측정기
용도
솔더크림의 유동성(칙소지수, 점도, 비회복율) 평가
사양
측정범위: 5.0 pa.s ~ 999.9 pa.s
교반속도: 1 ~ 50 rpm
Sample size: 500 g

저속 전단강도 측정기
용도
Chip 접합부 다이 접합부에 대한 전단 응력 평가
솔더 볼 접합부에 대한 ball pull 평가
사양
시료크기: 4 mm ~ 84 mm
툴 이송정밀도: 0.1 μm
Die shear 용량: Max. 100 kg

고속 전단강도 측정기
용도
무연 솔더볼 접합부에 대한 고속 전단(충격) 평가
사양
Load: 3 kg
Test speed: Max. 4 m/s
Solder ball size: 300 ~ 450 μm

DSC
용도
금속 및 고분자 재료의 녹는점 측정
사양
온도범위 : -180 ~ 725 °C
온도제어정밀도 : 0.1 °C
온도측정정밀도 : 0.05 °C

TGA
용도
금속 및 고분자 재료의 열분해온도 측정
사양
온도범위 : RT ~ 1000 °C
무게 정밀도 : ± 0.01 %

TMA
용도
온도에 따른 재료의 치수 변화를 정밀하게 감 지하여 열팽창계수를 측정
사양
냉각장비 사용시: -70 ~ 400 °C
냉각장치 미사용시: RT ~ 1000 °C

FTIR
용도
적외선에 대한 고유 흡수 스펙트럼을 이용한 유기 분자의 정성분석 및 정량분석
사양
Source : Sic Source for mid-IR (9,600 ~ 20 cm-1)
Detector : DLaTGS Detector (12,500 ~ 350 cm-1)
Beamsplitter : Ge on KBr Beamsplitter (7,800 ~ 375 cm-1)
Spectral range : 7,800 ~ 650 cm-1
Resolution : better than 0.4 cm-1

레오미터
용도
재료의 점탄성 거동 분석
사양
Torque : 0.1 μN.m ~ 200 mN.m
Frequency : 1.2 E-7 ~ 100 Hz
Temperature range : -20 ~ 80 °C

만능 인장 시험기
용도
일정 strain, stress, deflection 하에서 반복 굽힘 시험에 따른 저항 및 물성변화 측정
사양
Capacity: 30 kN max.
Test speed: 0.001 to 508 mm/min. up to 30 kN
Crosshead travel range: Max. 855 mm
Column distance: 404 mm
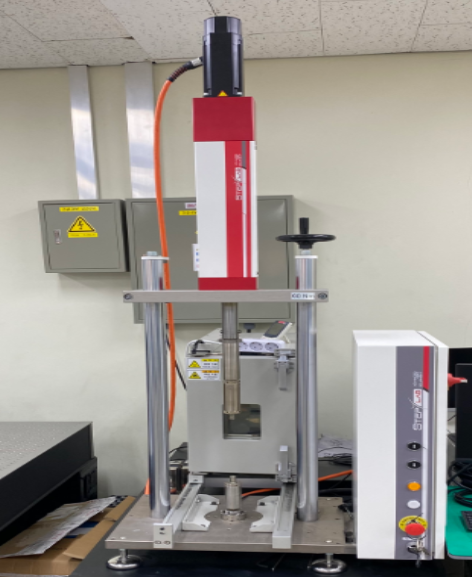
피로 시험기
용도
상온 또는 노출온도 (-50~200 °C)에서 저강도 금속, 박판, 고분자 재료에 대한 피로 내구성을 정밀 측정
반도체 패키징용 소재의 피로물성 측정 및 이를 활용한 실장 부품 및 기판 설계용 시뮬레이션 수행
사양
최대 동적/정적 시험용량: ± 1.5kN / ± 1.2 KN
피로시험 반복 주파수: ~35 Hz (적정 : 5 ~ 20 Hz)
챔버 온도 범위: -50 ~ 200°C

이온밀러
용도
구조손상과 오염없이 시료의 미세표면 구조를 선명하게 관찰하기 위해 시편 단면 가공
사양
Ion accelerating voltage : 2 to 8 kV or better
Ion-beam diameter : 500 um(full width at half maximum) or more
Milling speed : 500 μm / h or higher

SEM/EDS
용도
가속 전자를 이용한 전자 현미경을 사용하여 재료 내부 미세 구조 및 초정밀 접합부 불량 분석에 활용
EDS를 이용한 정성ᆞ정량 분석(area, point, mapping)
사양
분해능 : 3.5 mm at 0.5 kV
Beam Stability : 0.1 % / 10 min, 0.4 % / 10 hr
Magnification : N mode 40 ~ 400 K
Chamber size : 100 x 100 x 25 mm

광학 현미경
용도
금속재료, 전자재료, 세라믹재료, 기계 및 부품 등의 마이크로 조직 등을 광학계를 통해 관찰
사양
Min. graduation : 0.01 μm or more
최대 샘플 높이 : 25 mm or more
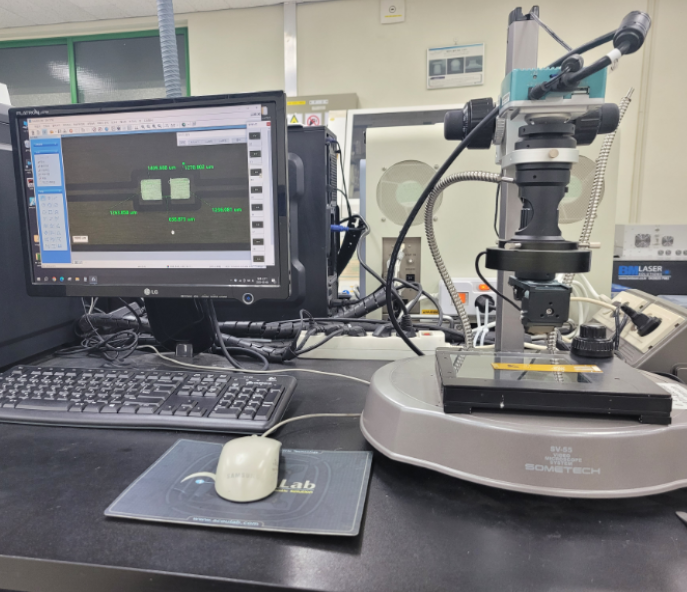
3D 현미경
용도
실장된 미세 부품 및 회로 기판을 2D/3D로 확대 관찰
사양
Zoom ratio: 0.3 x (7 x on monitor) ~ 2.2 x (300 x)
FOV/WD: 3.5 mm ~ 25 mm / 95 mm

SMT Scope
용도
온도 및 시간에 따른 솔더 접합부의 접합거동 관찰
Solder ball, solder bump, Electric parts etc.
사양
Chamber temperature : R.T ~ 400 °C
Temperature rate : Max. 360 °C / min
Chamber environment : Air, N2
Recoding time : Max. 198 h

알파스텝
용도
정밀부품의 표면조도 평가
FPCB의 Line Pitch 측정
시편의 스퍼터 증착량 및 도금 두께 측정 및 조도 평가
사양
Max. Line Length: 50 mm more
Tip radius: 2 μm
Vertical resolution: 최대 1 Å
Stylus force: 0.2 ~ 10 mg

SAM
용도
초음파를 이용한 기판 및 접합부의 비파괴 불량 검사
사양
해상도 : 0.5 μm
주파수: 10~75 MHz

X-ray
용도
X-선을 이용한 기판 및 접합부의 비파괴 불량 검사
사양
최대가속전압: 160 kV
최대전류: 1 mA
Sample size: 400 mm x 300 mm 50 kg 이하
최소초점크기 : 0.5 ~ 1 μm

열충격 시험기
용도
열충격 환경 및 열 피로 환경에 대한 미세접합부의 수명 및 내구성 평가
사양
시료부피: W470 × D650 × H410 mm
시료무게: 50 kg
고온/ 저온 챔버: +50 ~ +220 °C / -80 ~ +70 °C
온도적응시간: 15 min 이내 (12 kg ICs)
MIL 883 E, Method 1010.7 대응

열사이클 시험기
용도
자동차 전장품 및 마이크로조이닝 제품의 열 피로 환경에 대한 내구성 평가
사양
시료부피: W580 × D620 × H750 mm
온도범위: -70 ~ 180 °C
습도범위: 10 ~ 95 %RH
Heating rate : Max. 17 °C/min
Cooling rate : Max. 15 °C/min

진동 시험기
용도
전장 및 각종 패키징 부품의 진동 신뢰성 평가
탄성 스트레스 내구성 평가
사양
진동 가진력: 200 kgf
진동 주파수: 3 ~ 3000 Hz
최대속도 1.4 m/s
최대변위: 50 mm 이상

이온 마이그레이션&항온항습 챔버
용도
이온 migration 평가/ 절연 열화 특성 평가
BGA, CSP등 미세피치패턴, 콘덴서, 연결기외 전자 부품이나 재료/ 각종 절연 재료의 흡습 특성 평가
전자부품 및 회로기판의 항온항습 신뢰성 테스트
사양
인가전압 범위: DC (1~100)V, 0.1 V 단위 제어가능 및 DC 0 V
측정전압 범위: DC (1~100)V, 0.1 V 단위 제어 가능
인가전압과 측정 전압은 별도 설정 가능
온도 범위 : Max. 100 °C
습도 범위 : Max. 90 %

HAST
용도
전자 패키징 부품의 초기불량을 제어하기 위해 시료에 가속화된 응력 및 온도를 인가하여 신뢰성 평가
사양
시험온도 & 습도 범위: 105 to 151 °C at 100 %RH, 109 to 159 °C at 85 %RH, 125 to 160 °C at 50 %RH
시험 압력 범위: 0 to 0.4 Mpa
습도 설정: 50 to 100 %RH
챔버 내부 크기: 169 L
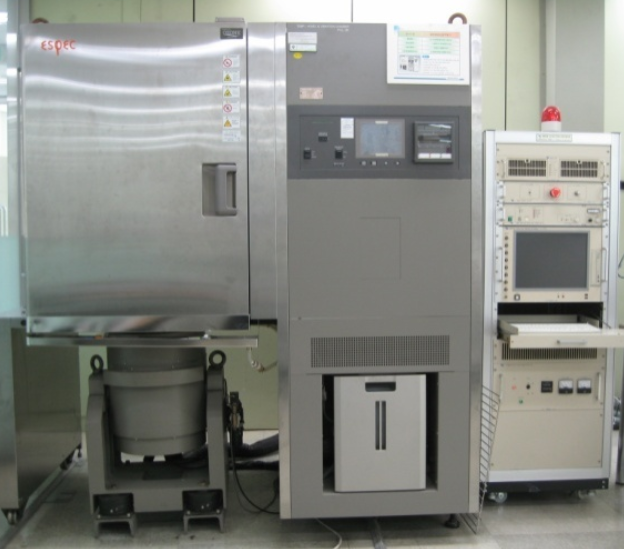
복합진동 시험기
용도
전장 및 각종 패키징 부품의 신뢰성 평가
항온항습, 진동, 복합환경시험 등의 내구성 평가
사양
온도범위 : -40 ~ 150 °C
습도범위 : 20 ~ 98 %RH
진동 가진력 / 주파수: 200 kgf / 3 ~ 3000 Hz
진동 주파수 : 최대속도 : 1.4 m/s
최대변위 : 50 mm 이상

HALT
용도
제품의 동작(파괴)한계 검출
원인분석을 통한 품질 개선
사양
온도범위 : -100 ~ 200 °C
온도변화율 : 60 °C / 분
진동주파수 : 20 ~ 10 KHz