연구
반도체 패키지 인터커넥션 기술
와이어 본딩
얇은 금속 와이어를 사용하여 직접회로(IC)나 다른 전자 부품을 기판 또는 다른 장치에 연결하는 반도체 패키징 기술
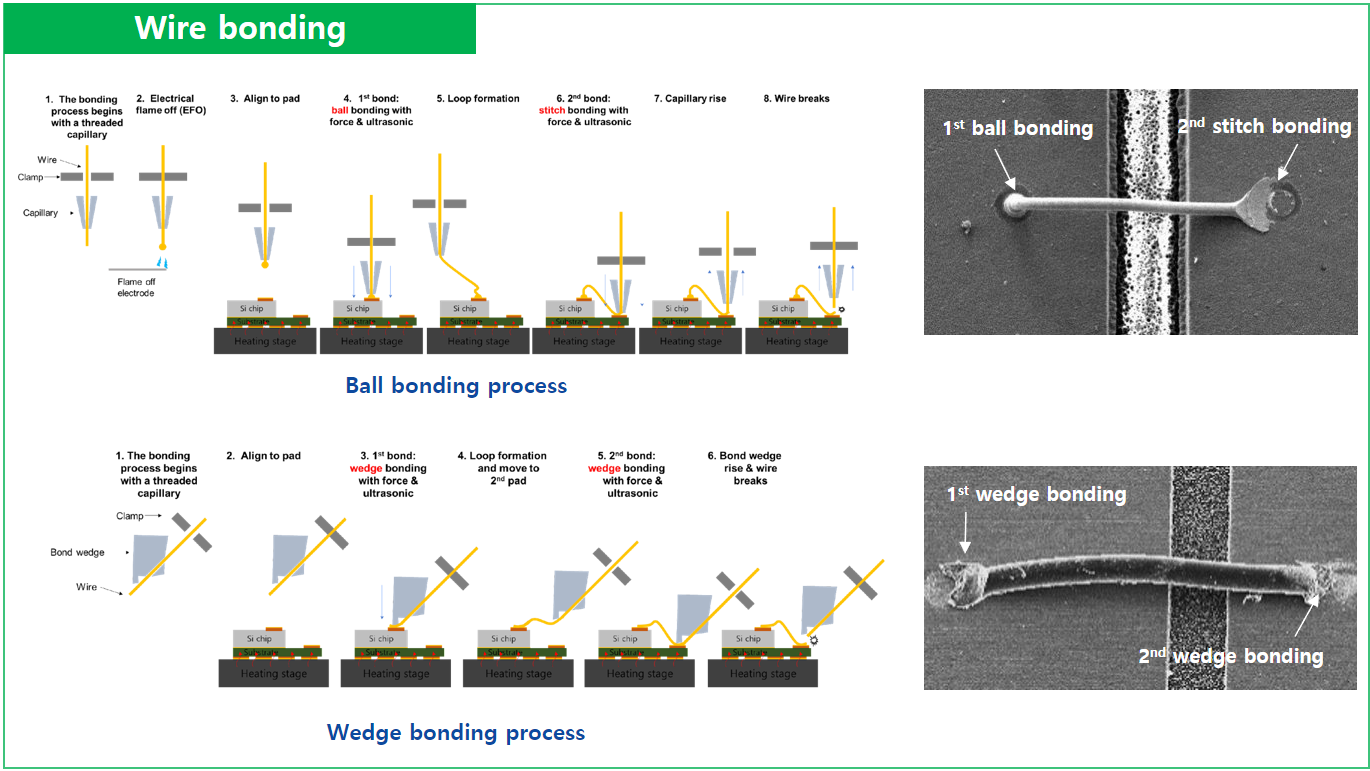
Introduction
와이어 본딩은 가장 오래되고 널리 사용되는 전통적인 1차 레벨 패키징 접합 방식으로 다양한 전자 부품의 적용되고 있다. 자동차의 전력 반도체 연결, 조명의 LED 소자 연결 등이 있으며, 최근 메모리 반도체 소자를 쌓아 올려 연결하는 방식에도 사용되고 있다. 와이어 본딩 재료로써 사용되는 금속은 금(Au), 구리(Cu), 알루미늄 (Al), 그리고 은(Ag)이 있으며, 그 중 금(Au) 와이어가 널리 사용되고 있다. 와이어 본딩 방식은 크게 볼 본딩과 웻지 본딩으로 나뉘어 지며, 열 또는 초음파를 사용하여 압착하는 방식으로 접합된다.
플립칩 접합
Flip-chip bonding이란 말 그대로 소자가 형성된 활성화면에 솔더 범프를 형성하여 아래로 향하게 하여 기판의 패드와 상호 연결하는 방식이며, wire bonding 기술에서 발전한 접합방식 이다.
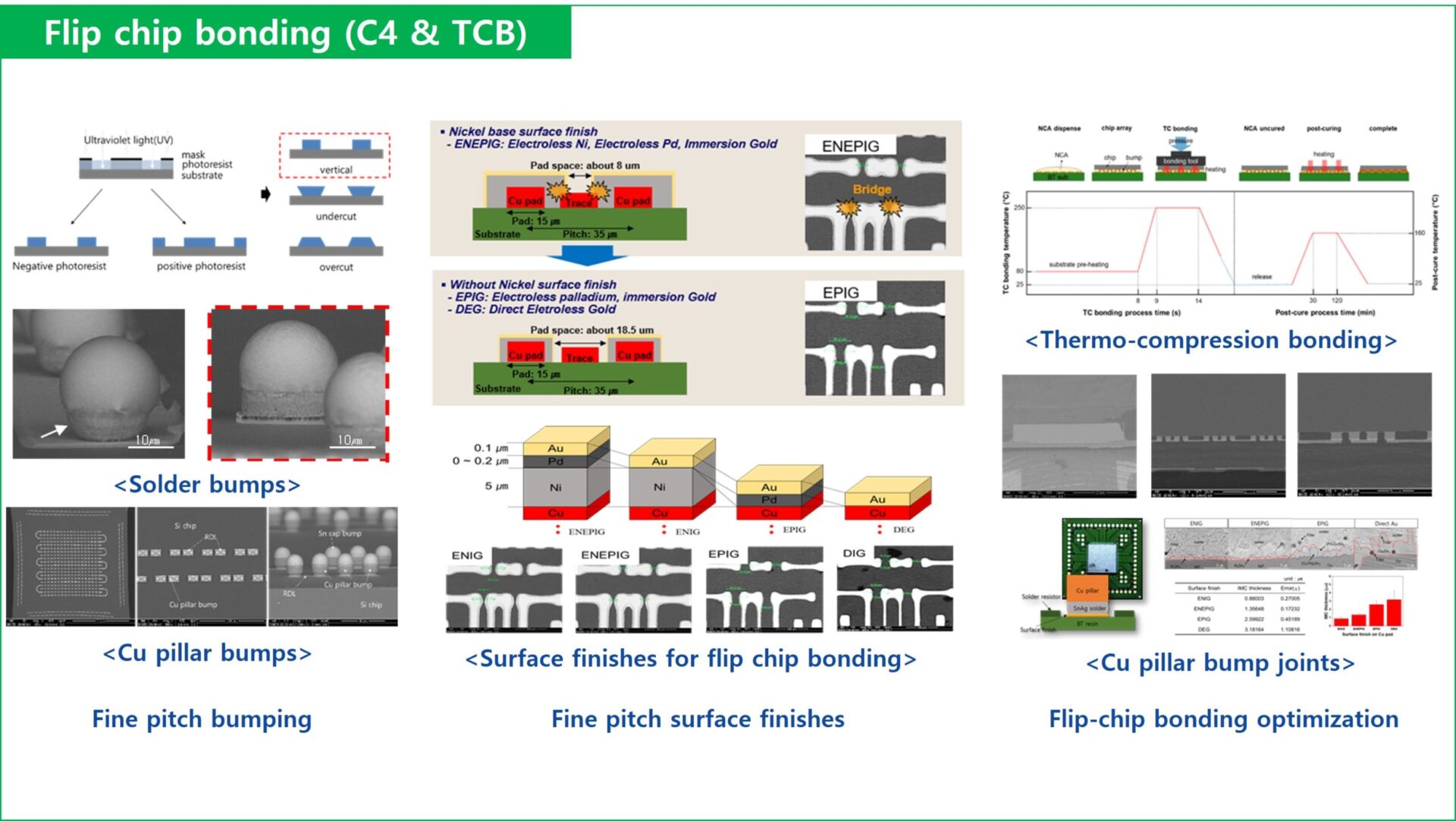
Introduction
Flip-chip bonding은 기존의 wire bonding에서 발전된 접합 방식이다. Wire bonding의 경우 칩 외각을 이용하여 접합하는 반면, Flip-chip bonding은 전면의 범프를 사용하여 입출력 단자 수를 크게 증가시킬 수 있는 장점이 있다. 또한, 솔더를 통해 칩에서 발생하는 열을 쉽게 방출할 수 있어 열 관리 측면에서도 이점을 가지는 방식이다. 이는 첨단 패키지 제작을 위한 기초적인 접합 방식으로 분류될 수 있으며, Mass reflow (MR) 공법을 사용하는 C4(controlled collapse chip connection) 공정과 열과 압력을 이용하는 열압착(Thermal compression bonding, TCB) 공정으로 구분된다.
언더필 공정
언더필이란 에폭시 소재로 칩과 캐리어 또는 패키지와 PCB 기판 사이에 도포하여 전자 제품을 보호하는 역할
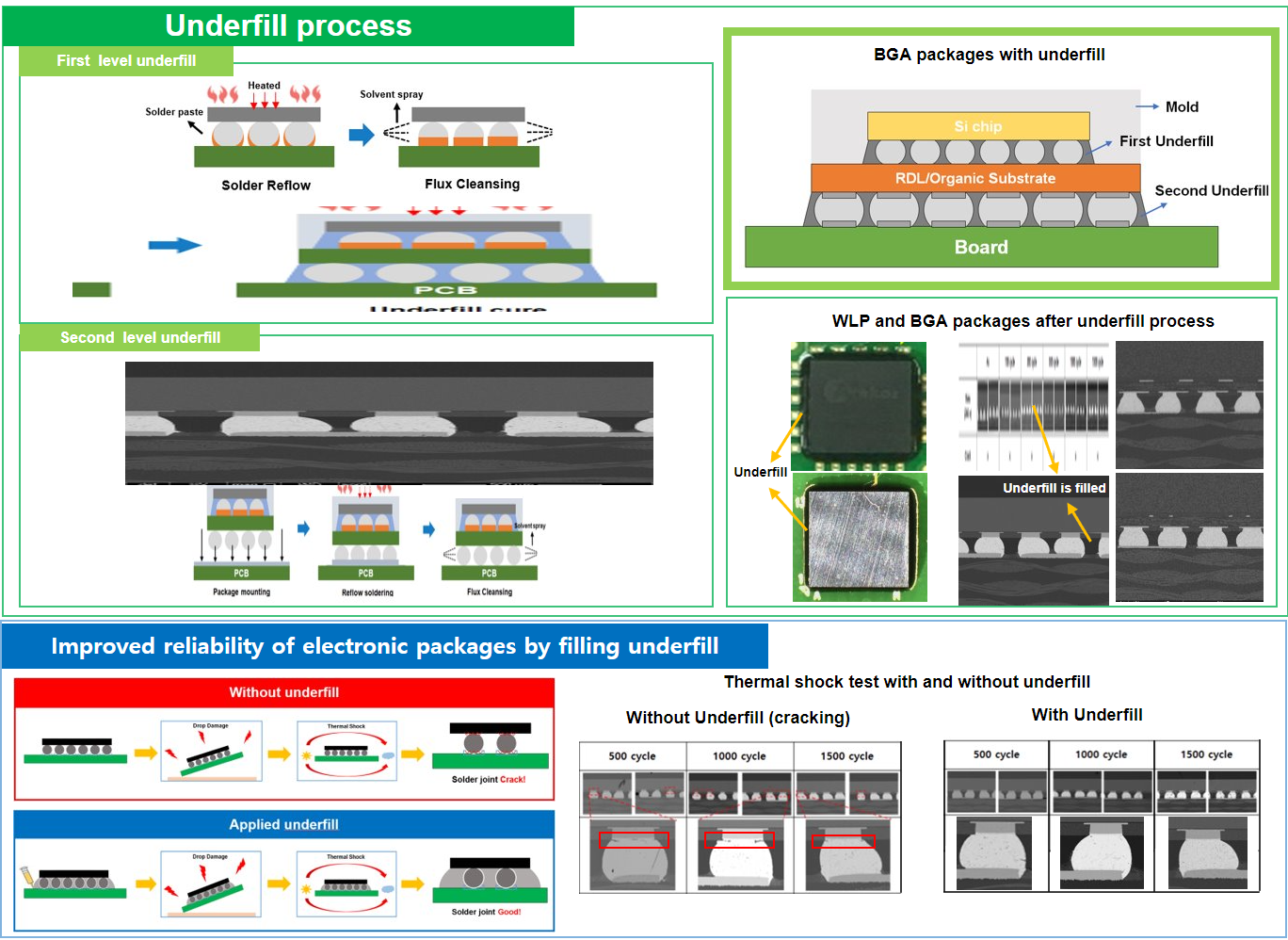
Introduction
에폭시 소재인 언더필(Underfill)은 충격과 낙하와 같은 일상에서 오는 화학적, 물리적 충격으로 부터 반도체 패키지를 보호한다. 전자 패키지 실장 기술의 발전과 패키지의 고성능화 ,경령화 되며 반도체 칩과 PCB 기판과의 접합부도 미세화 됨에 따라 접합부의 신뢰성이 중요해지고 있다. 언더필은 칩과 캐리어 또는 반도체 패키지와 PCB 기판 사이에 도포되며 열팽창계수 차이로 인해 솔더 접합부에 집중되는 응력을 고르게 분산 및 완하시킴으로써 반도체 패키지의 신뢰성을 향상 시키는 역할을 한다.
레이저 어시스트 본딩 (LAB)
LAB 란 레이저 빔을 균질시켜 사각형의 형태로 만들어 넓은 면적에 레이저를 조사하는 방식을 이용하여, 수 밀리초 이내에 국부적으로 칩 또는 부품을 접합하는 공정
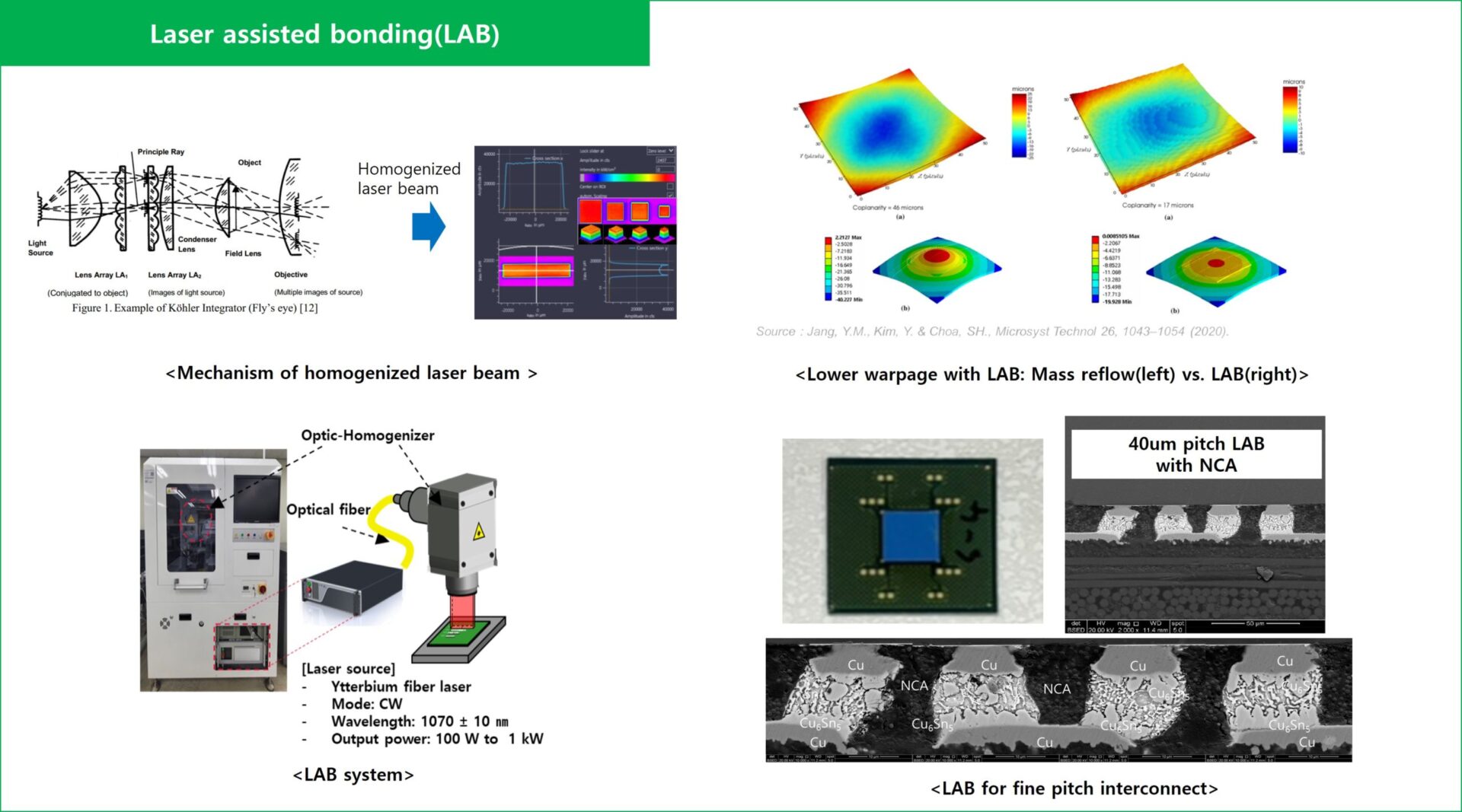
Introduction
일반적으로 반도체 패키지 접합 방식으로 사용되는 Mass Reflow 공정은 공정 시간이 길어서 소자의 열 손상(기판 휨 현상) 및 열 전달의 불 균일성과 같은 한계점을 가지고 있다. 이를 극복하기 위해 균질화된 레이저 빔을 활용한 Laser Assisted Bonding (LAB) 공정이 도입되었다. LAB 공정은 높은 선택적 열 전달 및 빠른 공정 속도를 제공하여 Mass Reflow 공정을 대체하는 접합 방식으로 주목 받고 있다. 첨단 전자 산업에서 사용되는 반도체 전자 부품은 점점 경박 단소되며, 이에 따라 얇아지는 칩과 기판의 휨 현상을 효과적으로 대처할 수 있는 공법 중 하나이다.
하이브리드 본딩
하이브리드 본딩이란 반도체 제품을 조립할 때 칩의 패드와 외부 단자를 도선으로 연결해 서로 다른 기능을 하는 칩셋을 혼합하는 기술
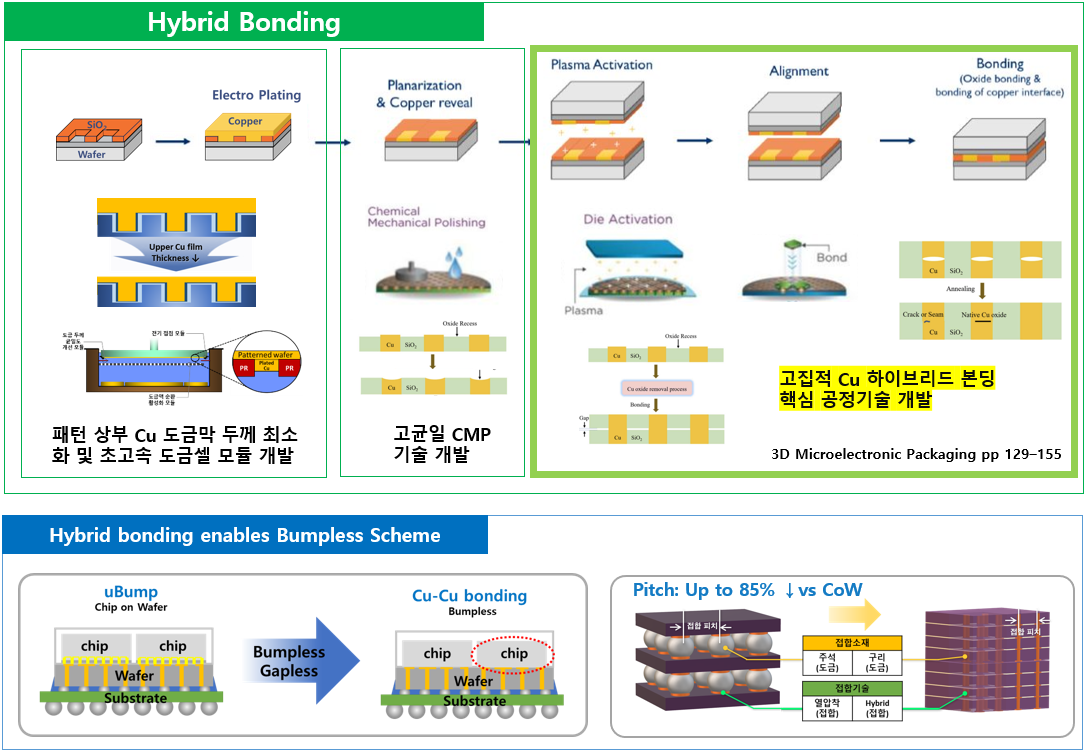
Introduction
하이브리드 본딩은 기존의 전통적인 범프 사용을 제거하고 작은 구리-구리 연결을 통해 패키지 내의 다이들을 연결하는 신뢰할 수 있는 대안으로 부상하고 있다. 이 혁신적인 접근 방식은 10µm 이하의 작은 간격(pitch)을 달성할 수 있다. 하이브리드 본딩을 활용함으로써 인터커넥트 밀도가 크게 향상되어 고급 메모리 큐브와 3D 형태의 패키지를 구현할 수 있다. 이 본딩 과정은 절연체 본딩(SiOx)과 내장된 금속(Cu)을 결합하여 영구적인 연결을 형성한다. 이 산업에서는 이를 직접 본딩 인터커넥트(Direct Bond Interconnect, DBI)라고도 부르며, 하이브리드 본딩은 퓨전 본딩에 내장된 금속 패드를 사용하여 본딩 인터페이스에 직접적인 면대면 연결을 가능하게 한다.