연구
첨단 표면실장기술
표면실장기술
인쇄회로기판에 솔더 페이스트를 인쇄하고 전자부품을 고속으로 실장한 뒤 리플로우를 통하여 부품과 기판 패드를 전기적 기계적으로 연결하는 기술

Introduction
표면 실장 기술(SMT)은 기본적으로 인쇄 회로 기판과 관련된 부품 조립 기술로, 배치 솔더-리플로우 공정을 사용하여 기판 표면에 부품을 부착하고 연결한다. SMT는 도금된 스루홀 삽입 프로세스보다 높은 패키징 밀도, 높은 신뢰성 및 비용 절감을 달성할 수 있는 장점이 있다. 또한 SMT는 현재 저가이면서 고생산성 전자제품 조립에 가장 널리 사용되는 공정이다. 하지만 제품의 복잡성 증가, 부품 크기 감소, 양면 보드 사용으로 인해 재작업이 더욱 어려워졌으며 PCB의 경제적인 재작업은 모듈 제조업체가 직면한 주요 문제 중 하나이다.
레이저솔더링/실장
레이저 솔더링 짧은 시간 내에 솔더링이 가능하며 비접촉으로 국부 솔더링이 가능하여 주위에 열 영향을 주지 않는 공정
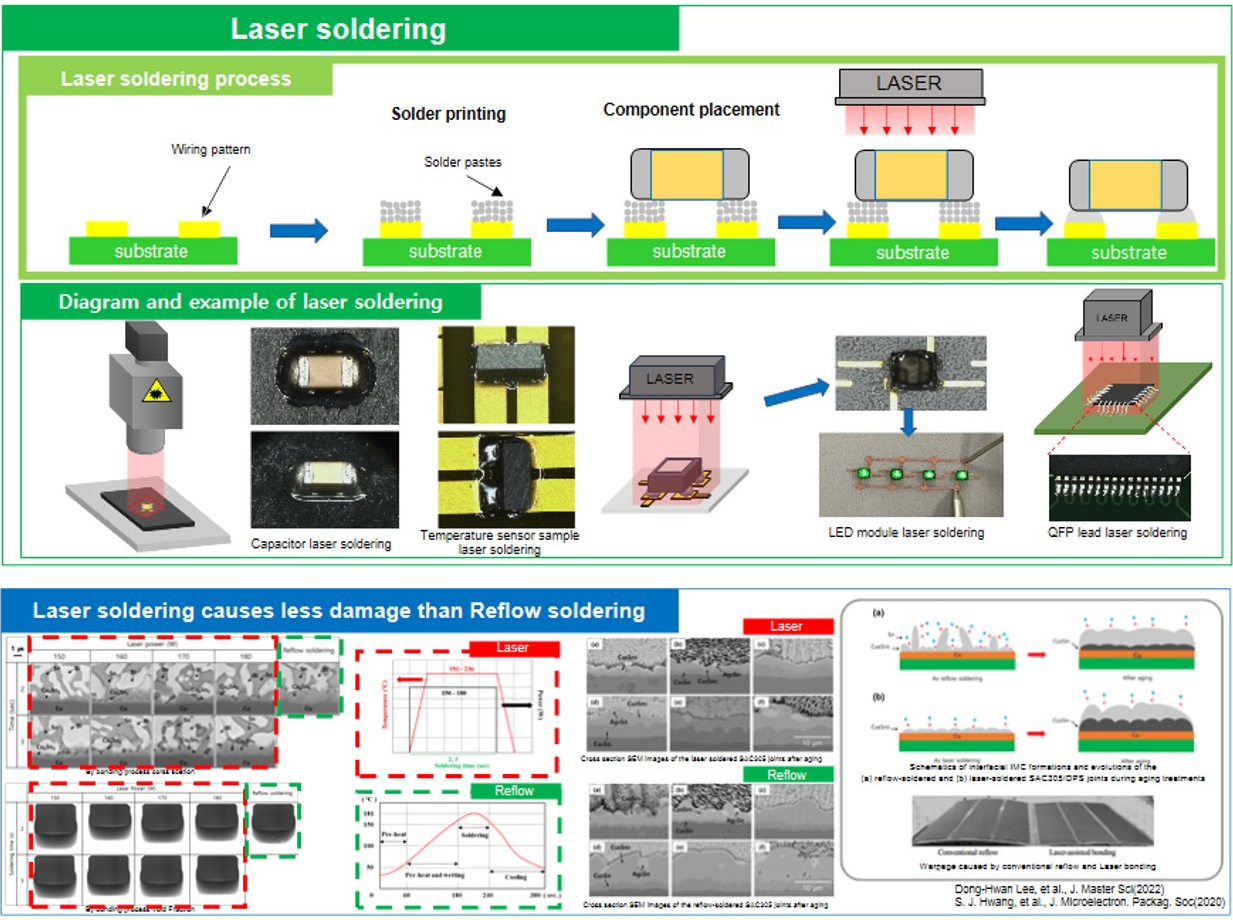
Introduction
레이저 솔더링은 기존의 리플로우 솔더링의 긴 공정 시간이라는 단점을 보완하여 짧은 시간 내에 솔더링이 가능해짐으로서 열 영향부 최소화라는 강점을 가지고 부상하고 있다.
현재 전자 패키징 분야에서는 SAC계열 솔더를 많이 사용되고 있으며 이로 인하여 솔더링 부의 미세 조직과 솔더링 부에 생성되는 Cu-Sn계 금속간화합물(intermetallic compound, IMC)는 형상과 두께에 따라 솔더부 특성에 영향을 미친다. 기존의 리플로우 솔더링에서 긴 공정 시간으로 인한 IMC 성장, 패키지 휨 및 접합부 결함 등을 레이저 솔더링을 활용함으로써 IMC 성장 완화, 패키지 및 PCB의 손상을 최소화 하여 패키지 휨을 감소시킬 수 있다.
소결 다이 접합
전력반도체 소자 (Die)를 방열·절연회로 기판에 금속 페이스트를 활용하여 녹이지 않고 접합하는 기술로, 이는 전력반도체 소자를 기계적으로 강건하게 유지하며 고온 동작에 견디도록 할 수 있는 접합 기술

Introduction
소결 다이접합은 차세대 전력반도체 소자(wide band-gap; WBG 반도체)인 SiC, GaN, Ga2O3의 실용화에 대응하기 위해 떠오르고 있는 차세대 전력반도체소자 접합 기술로, 최근 테슬라 모델3에 그 기술이 적용되면서 실용화기술로 확산되고 있다. WBG 전력반도체는 우수한 전기적 열적 특성을 기반으로, 기존 Si 대비 고전압 및 고속 스위칭 동작이 가능하기 때문에, Si 대비 더 높은 동작 온도 (약 200 °C이상)에서도 안정적인 동작이 기대되고 있다.소결 다이접합 기술의 핵심 메커니즘은, 고전도성 금속 (즉, Ag, Cu 등)의 높은 융점 (약 1000 °C) 대비 현저히 낮은 공정 온도 (약 300 °C 이하)로, 접합하여, 차세대 전력반도체의 고전압 구동에서도 안정적으로 동작할 수 있으며, 동시에 효과적인 방열 성능을 구현하는 것이다.